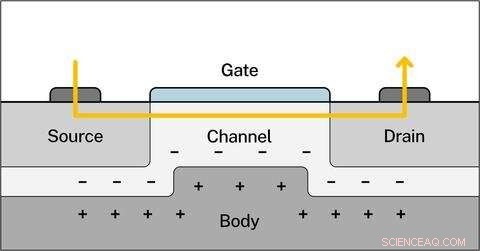
Durante a operação normal do transistor, um canal condutor (controlado pelo portão) se forma entre a fonte e o dreno, permitindo que uma corrente flua. Crédito:Sean Kelley / NIST
Pesquisadores do Instituto Nacional de Padrões e Tecnologia (NIST) e colaboradores criaram e testaram um novo método altamente sensível de detecção e contagem de defeitos em transistores - uma questão de preocupação urgente para a indústria de semicondutores à medida que desenvolve novos materiais para dispositivos de próxima geração. Esses defeitos limitam o desempenho do transistor e do circuito e podem afetar a confiabilidade do produto.
Um transistor típico é, para a maioria dos usos, basicamente um switch. Quando está ligado, a corrente flui de um lado de um semicondutor para o outro; desligá-lo interrompe a corrente. Essas ações criam respectivamente os 1s e 0s binários das informações digitais.
O desempenho do transistor depende criticamente de quão confiável uma determinada quantidade de corrente fluirá. Defeitos no material do transistor, como regiões de "impureza" indesejadas ou ligações químicas rompidas, interromper e desestabilizar o fluxo. Esses defeitos podem se manifestar imediatamente ou durante um período de tempo enquanto o dispositivo está funcionando.
Ao longo de muitos anos, os cientistas encontraram várias maneiras de classificar e minimizar esses efeitos.
Mas os defeitos se tornam mais difíceis de identificar conforme as dimensões do transistor tornam-se quase inimaginavelmente pequenas e as velocidades de chaveamento muito altas. Para alguns materiais semicondutores promissores em desenvolvimento - como carboneto de silício (SiC) em vez de silício (Si) sozinho para novos de alta energia, dispositivos de alta temperatura - não há uma maneira simples e direta de caracterizar os defeitos em detalhes.
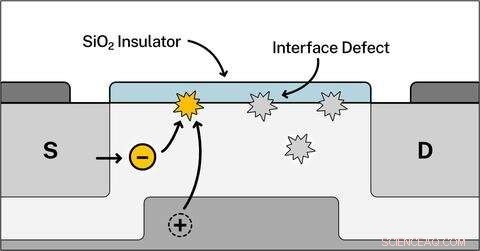
Contudo, elétrons que se movem da fonte para o dreno podem encontrar defeitos que levam à recombinação com um buraco, resultando em perda de corrente e tornando o transistor não confiável. Os mais importantes são chamados de defeitos de interface, existente na interface entre o óxido de silício e as camadas de silício. Crédito:Sean Kelley / NIST
"O método que desenvolvemos funciona com Si e SiC tradicionais, permitindo-nos, pela primeira vez, identificar não apenas o tipo de defeito, mas também o número deles em um determinado espaço com uma simples medição DC, "disse James Ashton do NIST, que conduziu a pesquisa com colegas do NIST e da Pennsylvania State University. Eles publicaram seus resultados em 6 de outubro no Journal of Applied Physics . A pesquisa se concentra nas interações entre os dois tipos de portadores de carga elétrica em um transistor:elétrons com carga negativa e "buracos com carga positiva", "que são espaços onde falta um elétron na estrutura atômica local.

Para contar esses defeitos, os pesquisadores colocam o transistor no modo de “amplificação bipolar” aplicando uma tensão à fonte e ao portão. Isso cria uma concentração decrescente de elétrons no canal. Nesta configuração, a corrente da fonte ao dreno é altamente sensível a defeitos de interface. Crédito:Sean Kelley / NIST
Quando um transistor está funcionando corretamente, uma corrente de elétron específica flui ao longo do caminho desejado. (Os buracos também podem formar uma corrente. Esta pesquisa explorou a corrente de elétrons, o arranjo mais comum.) Se a corrente encontrar um defeito, elétrons são presos ou deslocados, e pode então se combinar com orifícios para formar uma área eletricamente neutra em um processo conhecido como recombinação.
Cada recombinação remove um elétron da corrente. Múltiplos defeitos causam perdas de corrente que levam ao mau funcionamento. O objetivo é determinar onde estão os defeitos, seus efeitos específicos, e - idealmente - o número deles.
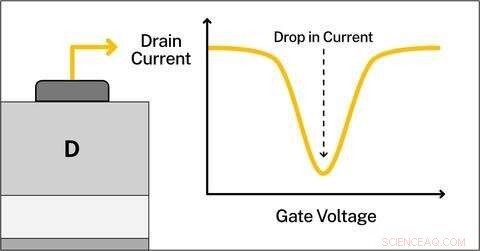
Ao monitorar a corrente no dreno enquanto varia a tensão da porta, os pesquisadores podem determinar com precisão o número de defeitos da queda na corrente. Crédito:Sean Kelley / NIST
"Queríamos fornecer aos fabricantes uma maneira de identificar e quantificar defeitos enquanto testam novos materiais diferentes, "disse o co-autor do NIST, Jason Ryan." Fizemos isso criando um modelo físico de uma técnica de detecção de defeitos que tem sido amplamente usada, mas mal compreendida até agora. Em seguida, conduzimos experimentos de prova de princípio que confirmaram nosso modelo. "
Em um design clássico de semicondutor de óxido de metal (veja a figura), um eletrodo de metal denominado portão é colocado sobre uma fina camada isolante de dióxido de silício. Abaixo dessa interface está o corpo do semicondutor.
De um lado do portão está um terminal de entrada, chamada de fonte; do outro, uma saída (dreno). Os cientistas investigam a dinâmica do fluxo de corrente, alterando as tensões de "polarização" aplicadas à porta, fonte e dreno, todos os quais afetam o modo como a corrente se move.
No novo trabalho, os pesquisadores do NIST e da Penn State se concentraram em uma determinada região que normalmente tem apenas cerca de 1 bilionésimo de metro de espessura e um milionésimo de metro de comprimento:o limite, ou canal, entre a fina camada de óxido e o corpo semicondutor em massa.
"Esta camada é extremamente importante porque o efeito de uma voltagem no overtop de metal do óxido do transistor age para alterar quantos elétrons estão dentro da região do canal sob o óxido; esta região controla a resistência do dispositivo da fonte ao dreno, "Ashton disse." O desempenho desta camada depende de quantos defeitos existem. O método de detecção que investigamos anteriormente não foi capaz de determinar quantos defeitos havia nesta camada. "
Um método sensível para detectar defeitos no canal é chamado de ressonância magnética detectada eletricamente (EDMR), que é semelhante em princípio à ressonância magnética médica. Partículas como prótons e elétrons têm uma propriedade quântica chamada spin, o que os faz agir como minúsculos ímãs em barra com dois pólos magnéticos opostos. Em EDMR, o transistor é irradiado com microondas em uma frequência cerca de quatro vezes maior do que um forno de microondas. Os experimentadores aplicam um campo magnético ao dispositivo e variam gradualmente sua força enquanto medem a corrente de saída.
Exatamente na combinação certa de frequência e intensidade de campo, elétrons em defeitos "invertem" - invertem seus pólos. Isso faz com que alguns percam energia suficiente para se recombinarem com orifícios nos defeitos do canal, reduzindo a corrente. A atividade do canal pode ser difícil de medir, Contudo, porque o alto volume de "ruído" da recombinação na maior parte do semicondutor.
Para focar exclusivamente na atividade do canal, pesquisadores usam uma técnica chamada efeito de amplificação bipolar (BAE), que é conseguido organizando as tensões de polarização aplicadas à fonte, portão e dreno em uma configuração particular (veja a figura). "Portanto, por causa da polarização que usamos no BAE e porque medimos os níveis de corrente no dreno, "Ashton disse, "podemos eliminar a interferência de outras coisas que acontecem no transistor. Podemos selecionar apenas os defeitos com os quais nos preocupamos dentro do canal."
O mecanismo exato pelo qual o BAE opera não era conhecido até que a equipe desenvolveu seu modelo. "Os únicos resultados de medição foram qualitativos, ou seja, eles sabiam os tipos de defeitos no canal, mas não o número, "disse o co-autor Patrick Lenahan, um distinto professor de ciência da engenharia e mecânica na Penn State.
Antes do modelo da BAE, o esquema foi usado estritamente como um recurso para aplicar tensões e controlar correntes para medições EDMR, o que é útil para uma identificação de defeitos mais qualitativa. O novo modelo permite que o BAE seja uma ferramenta para medir quantitativamente o número de defeitos e fazer isso apenas com correntes e tensões. O parâmetro de importância é a densidade do defeito da interface, que é um número que descreve quantos defeitos existem em alguma área da interface semicondutor-óxido. O modelo BAE oferece aos pesquisadores uma descrição matemática de como a corrente BAE está relacionada à densidade do defeito.
O modelo, que os pesquisadores testaram em um conjunto de experimentos de prova de conceito em transistores semicondutores de óxido metálico, torna as medições quantitativas possíveis. "Agora podemos contabilizar a variação na distribuição da operadora de carga em toda a região do canal, "Ashton disse." Isso abre as possibilidades do que pode ser medido com uma simples medição elétrica. "
"Esta técnica pode fornecer uma visão única sobre a presença desses defeitos desestabilizadores do transistor e um caminho para a compreensão mecanicista de sua formação, "disse Markus Kuhn, anteriormente na Intel e agora diretor sênior de metrologia de semicondutores e membro da Rigaku, que não participou da pesquisa. "Com tanto conhecimento, haveria maior oportunidade de controlá-los e reduzi-los a fim de melhorar o desempenho e a confiabilidade do transistor. Esta seria uma oportunidade para aprimorar ainda mais o design do circuito do chip e o desempenho do dispositivo, levando a produtos com melhor desempenho. "
Esta história foi republicada por cortesia do NIST. Leia a história original aqui.