 p Uma reconstrução tridimensional dos recursos do chip a partir de medições usando o método de biblioteca de modelos NIST.
p Uma reconstrução tridimensional dos recursos do chip a partir de medições usando o método de biblioteca de modelos NIST.
p À medida que as dimensões dos recursos do microchip se aproximam da escala atômica, torna-se terrivelmente difícil medir seu tamanho e forma. De acordo com o International Technology Roadmap for Semiconductors, nos próximos dois anos, o comprimento típico da "porta" de um transistor - sua chave liga-desliga - será de menos de 20 nanômetros. p Atender às tolerâncias de produção para dispositivos com essas dimensões exigirá medições com uma incerteza mínima em torno de 0,3 nm. E a tarefa deve ficar mais difícil:em 2020, espera-se que os comprimentos da porta diminuam para cerca de 12,5 nm, exigindo incertezas na faixa de 0,2 nm - aproximadamente a largura de um átomo de silício.
p Isso coloca uma pressão extraordinária sobre os fabricantes de chips para melhorar o controle do processo. Em geral, os fabricantes medem as dimensões críticas de um portão (ou qualquer recurso), detectando suas bordas, usando um instrumento chamado microscópio eletrônico de varredura (MEV). SEMs medem o número de elétrons de baixa energia ejetados de uma amostra quando ela é atingida por um feixe de elétrons de alta energia; essas quantias são mais altas nas bordas. A imagem SEM típica usa algoritmos de aproximação que definem a posição da borda dentro de uma faixa possível de um ou dois nanômetros.
p Agora, os pesquisadores do NIST determinaram que um componente importante dessa incerteza é que, na escala ultrapequena dos recursos mais recentes do chip, As medições SEM são fortemente afetadas por variações na forma tridimensional do portão que podem ocorrer no curso da fabricação, incluindo a largura da linha e a posição central, o ângulo formado pelas paredes laterais de um recurso elevado, o raio de curvatura da área da borda superior, e o efeito de estruturas adjacentes. As diferenças em cada parâmetro alteram os caminhos dos elétrons ejetados da amostra, o que, por sua vez, torna difícil localizar as bordas com precisão e, assim, determinar a largura e a forma reais.
p Atualmente, esses efeitos geralmente não são levados em consideração no curso do controle do processo. Os fabricantes costumam comparar uma execução de produção com outra, assumindo que quaisquer variações entre os dois são o resultado de uma combinação de diferenças reais na dimensão relevante e erros de medição aleatórios. Mas de fato, Cientistas do NIST dizem, essas variações podem realmente ser o resultado de diferenças na forma tridimensional (algumas das quais não são a dimensão relevante) dos mesmos recursos de uma execução para outra. "A indústria de semicondutores claramente precisa de algo que possa lidar com formas tridimensionais arbitrárias , "diz John Villarrubia do NIST, autor principal do relatório. "O problema é que se o número da dimensão crítica que você está obtendo é sensível não apenas à largura da linha, mas também ao formato da linha, então você está medindo ambos de uma forma mal definida. "
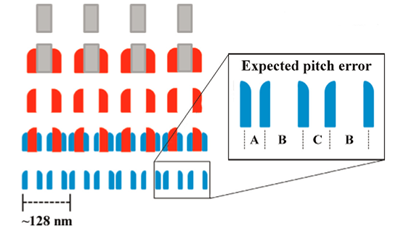 p Estágios de gravação sucessivos usados para reduzir o tamanho do recurso podem resultar em uma variação considerável na forma e no passo - a distância entre os centros de dois recursos adjacentes.
p Estágios de gravação sucessivos usados para reduzir o tamanho do recurso podem resultar em uma variação considerável na forma e no passo - a distância entre os centros de dois recursos adjacentes.
p Para reduzir a incerteza, Os cientistas do NIST desenvolveram uma maneira de modelar como os caminhos dos elétrons ejetados do portão durante a varredura SEM são afetados por variações de forma e parâmetros do instrumento, como inclinação do feixe, brilho, Deslocamento, tamanho do feixe, e outros fatores. Eles combinaram a física do trânsito de elétrons com bancos de dados detalhados de transmissão e espalhamento de elétrons e usaram números aleatórios para simular a natureza probabilística do espalhamento de elétrons. Eles então repetiram o processo para cada um dos 27, 000 combinações diferentes de parâmetros. O resultado é uma biblioteca de assinaturas SEM correspondentes a diferentes combinações de formas. As assinaturas de MEV medidas podem ser comparadas à biblioteca para inferir com precisão os parâmetros da amostra.
p Os cientistas do NIST fizeram parceria com a Intel Corporation para testar o método em amostras especiais fabricadas pela empresa para dimensões de próxima geração de 10 nm a 12 nm. Em uma publicação recente, os colaboradores relatam que, quando compararam os resultados das medições de largura e forma usando o sistema de biblioteca de modelos com as medições das mesmas portas por duas tecnologias de alta precisão completamente diferentes, o modelo NIST concordou com os métodos independentes para melhor que 1 nm.
p "Nenhum fabricante de circuitos integrados está usando este tipo de metrologia baseada em modelo no momento, "Diz Villarrubia." Mas eles poderiam adotar a técnica se os fabricantes de SEM começassem a incorporar essa capacidade em seus instrumentos. Isso pode aumentar significativamente a precisão das medições atuais.
p "Contudo, atendendo às demandas de medição de recursos ainda menores, com incertezas sub-nanométricas, exigirá modelos mais precisos, o desenvolvimento exigirá recursos de medição que atualmente não possuímos em nosso laboratório de pesquisa - por exemplo, a capacidade de medir o rendimento absoluto (quantos elétrons da amostra para cada elétron o SEM envia) em vez de rendimentos meramente relativos (quanta intensidade de um detector). Isso provavelmente exigirá instrumentação personalizada, em um momento em que o orçamento para manter a instrumentação existente já é um problema. "